- HOME
- 半導体パッケージ基板製造プロセス
IC Package
Substrate
Manufacturing Process半導体パッケージ基板製造プロセス
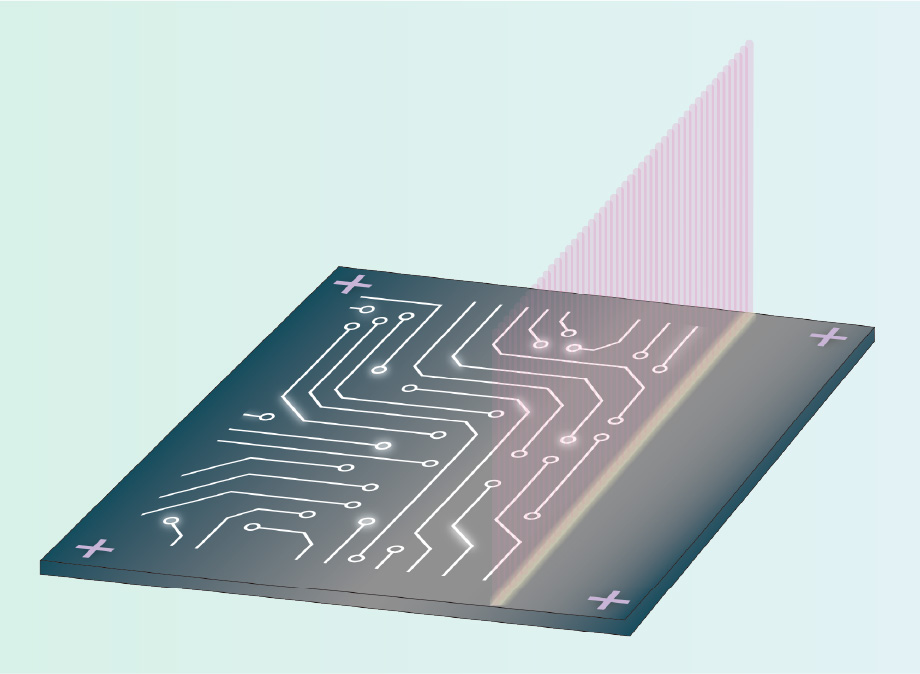
半導体の高性能化をコスト低減の面から支える技術として、回路を個片化して一つの半導体パッケージに収める「チップレット」が注目を集めています。先端半導体パッケージのチップレット間の接続には主にシリコンインターポーザーが使用されていますが、半導体パッケージの大型化や歩留、コストに課題を抱えています。
信越化学ではアブレーション加工によって、有機絶縁層に微細な電気回路パターンを掘り込むエキシマレーザー装置を開発しました。これにより、シリコンインターポーザーでしか達成できなかった微細配線や極小ビアを半導体パッケージ基板、再配線層(RDL)、有機インターポーザーなどに形成することができます。
半導体パッケージ基板製造プロセス動画

信越デュアルダマシン法の特長Shin-Etsu Dual Damascene Process Features
信越化学のエキシマレーザー装置を使用することで、半導体前工程で用いられるデュアルダマシン工法を後工程パッケージ基板製造に応用することが可能です。(信越デュアルダマシン法)
SAP(Semi-Additive Process)を代替する埋込配線法
-
信越デュアルダマシン法
レジストを使用せず、エキシマレーザーでビアや配線を加工するため、工程数の削減が可能です。
また、レーザードリルのような1by1の加工ではなく、加工スピードがビア数に依存しないスキャン加工で、テーパーの立ったビアを加工可能です。(レーザードリル代替)
-
従来のSAP+レーザードリルの課題
ドライフィルムレジストを使用するため、ラミネート、露光、現像プロセスが必要です。
また、レーザードリルによる1by1の加工のため、パネル当たりのビア数が増えると、その分加工時間がかかります。
微細かつ高精度な加工
信越独自の光学システムを使用することで、微細かつ高精度な加工が可能です。
-
信越デュアルダマシン法
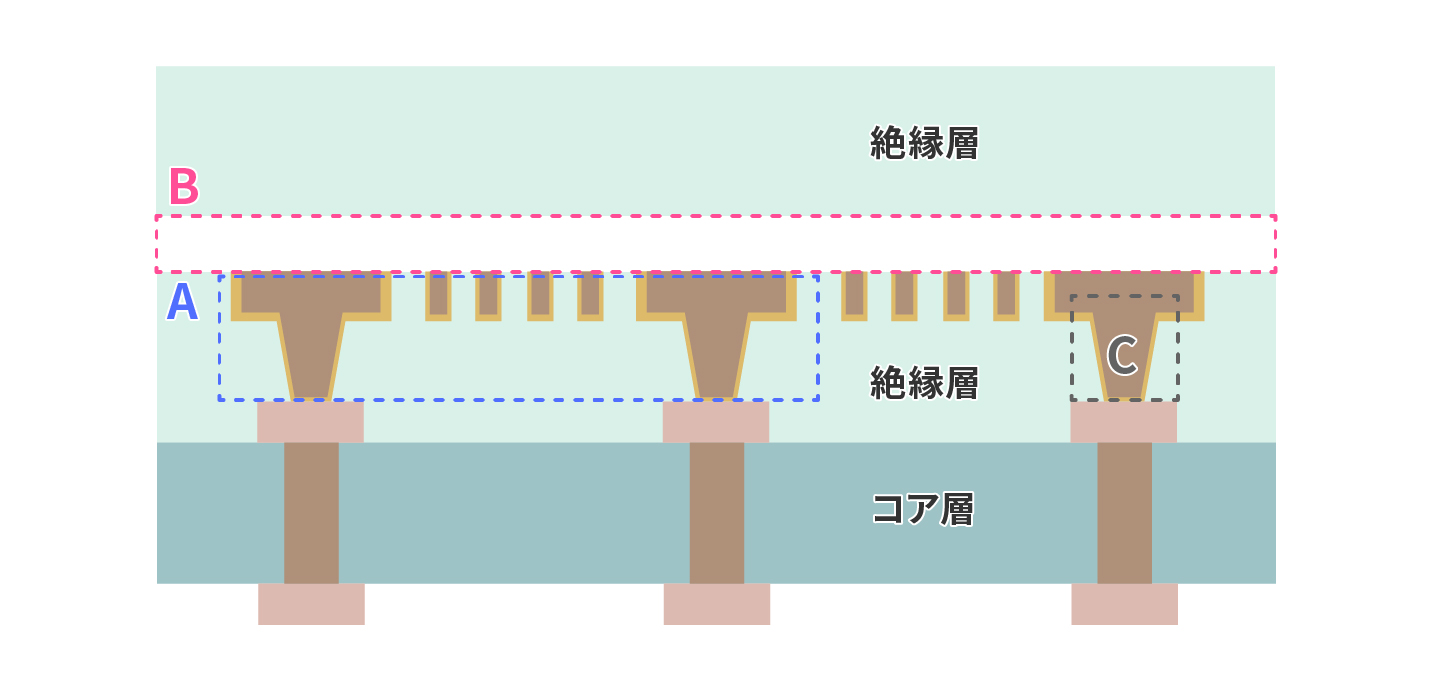
A【高精度なアライメント】
ビアと配線を一台の装置で加工するため、高いアライメント精度を達成することができます。B【埋込配線】
配線が絶縁層に埋め込まれているため、配線折れや有機絶縁膜の充填不足のリスクを低減可能です。C【高テーパー】
エキシマレーザーで加工することで、微細なビアや配線を高テーパーで加工可能です。 -
従来のSAP+レーザードリルの課題
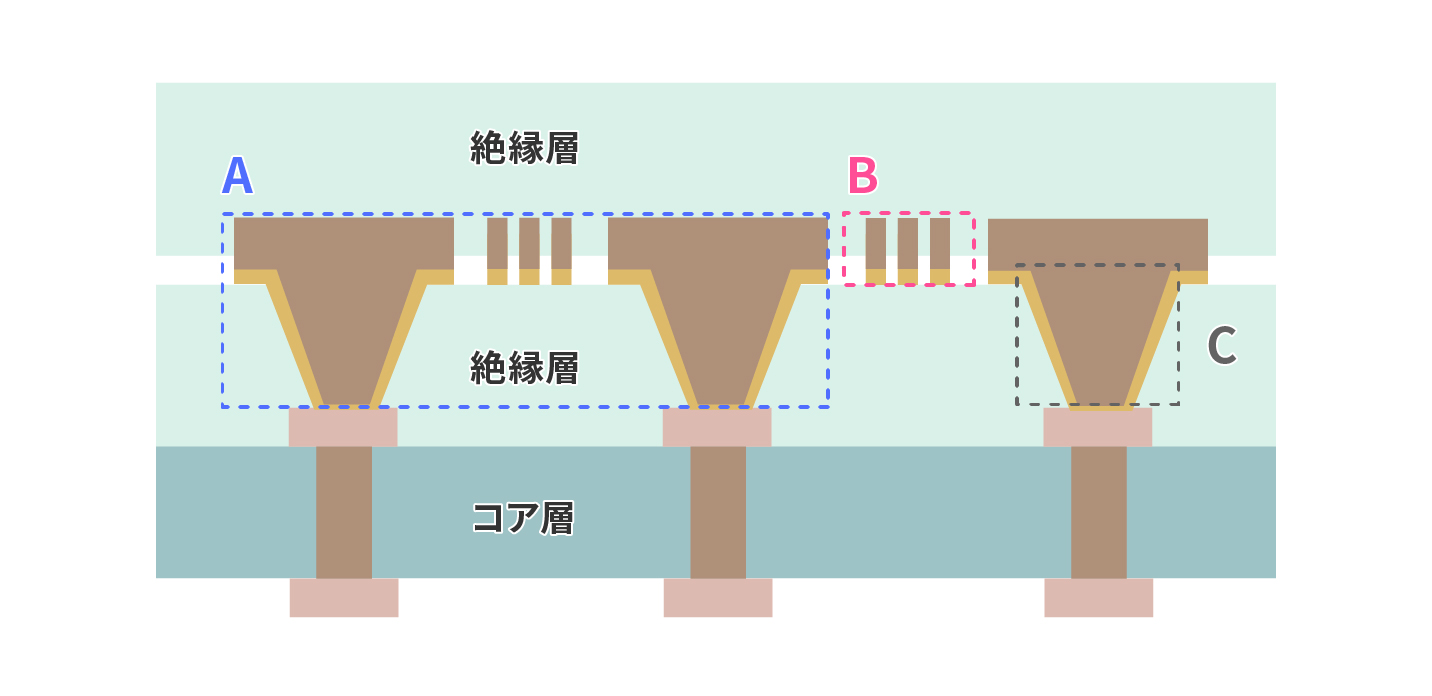
A【アライメント】
露光機とレーザードリルのアライメントが必要B【歩留】
ラミネート時の配線折れ・剥離や有機絶縁膜の充填不足リスクが高まるため、微細配線の形成が困難C【レーザードリルの加工精度】
ビアのテーパー、極小化、精度の限界
その他のアドバンテージやアプリケーション
半導体パッケージ基板に限らず、再配線層、有機インターポーザーなど様々な有機絶縁層への対応が可能です。
- 配線の細線化、ビアの小径化によるビルドアップ層の積層数を削減可能
- エキシマレーザー装置1台でレーザードリル複数台分のスループットがあるため、工場のフットプリントを削減可能
- 埋込配線のため、パッケージ基板・再配線層(RDL)の電気的な特性や信頼性の向上が見込まれる